Intel представила дизайн стеклянной подложки для упаковки чипов EMIB на выставке NEPCON 2026 в Японии
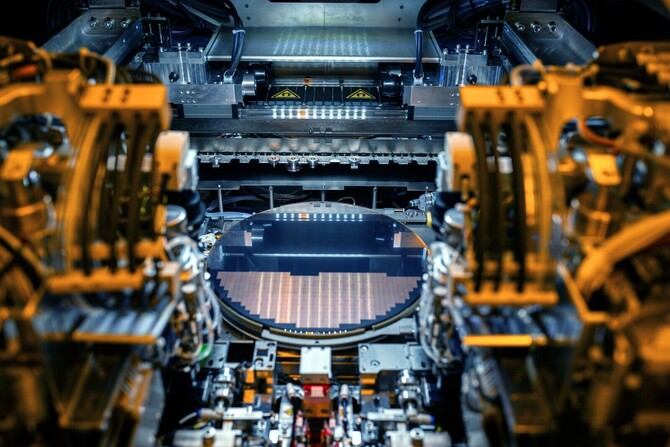
Давно известно, что технологический сектор все чаще обращается к использованию стеклянных подложек, которые в будущем заменят используемые в настоящее время органические подложки («плитки», расположенные под ядрами ЦП и ГП). Хотя в прошлом году по миру ходили слухи о том, что Intel откладывает разработку технологии Glass Core Substrate, компания их категорически опровергла, и первые результаты этой работы теперь были представлены на выставке NEPCON 2026 в Японии.
На выставке NEPCON 2026 в Японии компания Intel представила дизайн стеклянных подложек для упаковки чипов EMIB, предназначенных для серверных систем и приложений искусственного интеллекта.
Процессоры Intel Alder Lake достигли статуса EOL. Производитель отзывает свои первые гибридные системы из своего предложения
Intel — одна из первых компаний в мире, которая начала работу над производством и внедрением стеклянных подложек для производства процессоров, опередив даже TSMC. Эта технология обеспечивает большую глубину резкости при травлении дорожек, более высокую плотность соединений и более точные соединения между подложкой и кремниевыми сердечниками, и все это благодаря более твердому и жесткому материалу, которым является стекло. На выставке NEPCON 2026 в Японии компания Intel представила первый реальный дизайн такой подложки, правда, только в виде слайда. Технология Glass Core Substrate означает, что структура упаковки имеет многослойное расположение, называемое 10-2-10. Первые 10 уровней — это RDL (уровни перераспределения), металлические дорожки и межсоединения, которые активно перенаправляют сигналы и мощность между чипами и другими элементами пакета. Далее следуют два слоя стекла, которые обеспечивают высокую механическую жесткость и стабильность размеров, помогая уменьшить деформацию и искажение. В этом месте также имеются TGV (Through Glass Vias), то есть металлизированные каналы, проходящие через стекло, которые обеспечивают электрическое соединение между сторонами подложки. После ядра у нас снова есть 10 слоев RDL, которые создают пути передачи сигналов и мощности в направлении выводов корпуса.
Процессоры Intel Bartlett Lake почти наверняка не появятся на потребительском рынке
Вся конструкция имеет размеры 78х77 мм и подготовлена для реализации двух чиплетов и их взаимной связи с помощью двух мостов EMIB. Intel также сообщила, что расстояние между шариками микроприпоя (шаг выступа) составляет 45 мкм, что указывает на очень высокую плотность соединений в корпусе. На слайде также указано «No SeWaRe», что предполагает, что решение предназначено не для потребительского рынка, а для серверных продуктов и приложений искусственного интеллекта. Однако Intel не назвала конкретную дату внедрения упаковки EMIB, тогда как отраслевые анализы и отчеты о рынке позволяют предположить, что первоначальное внедрение решения начнется во второй половине 2026 года, а массовое производство и более широкое внедрение могут произойти в период с 2026 по 2027 год.
Подложку Intel со стеклянным сердечником, представленную на NEPCON Japan 2026, можно назвать только впечатляющей.
Больше всего выделяется исполнение. Речь идет не только о видении; сборка и надежность уже идут. Это ясно показывает, как Intel позиционирует подложки со стеклянным сердечником как… pic.twitter.com/9JNaCVe9pM
— SemiVision️️ (@semivision_tw) 22 января 2026 г.
Источник: Intel, WCCFTech, X (@semivision_tw)













