Intel представила новую стеклянную подложку для сложных чипов будущего с EMIB
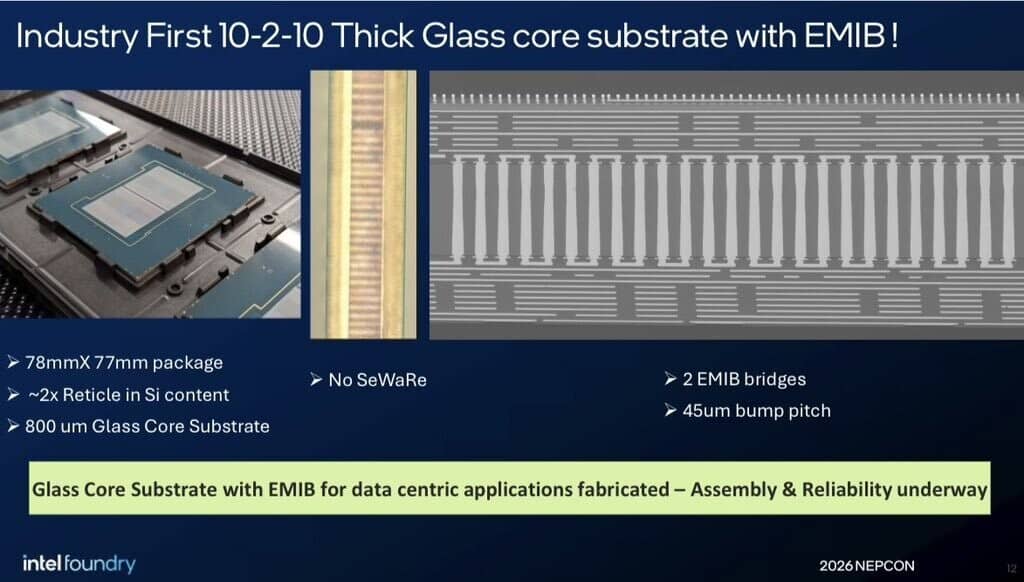
Intel представила на NEPCON Japan 2026 новую технологию стеклянных подложек, которая поможет производить чипы для ускорителей искусственного интеллекта и области высокопроизводительных вычислений.
Новая подложка Stunklen имеет размеры 78 × 77 мм, достаточные для всего корпуса чипа — она может вместить примерно вдвое больший размер фотопластины по сравнению с кремниевой — около 1716 мм² для логики и памяти. Это первая стеклянная подложка в конфигурации 10-2-10, поддерживающая технологию Intel EMIB для многочиповых модулей. Сверху размещены 10 слоев интерпозера RDL для перераспределения сигналов от кристалла.
Основа подложки двухслойная и изготовлена из материала толщиной 800 мкм (0,8 мм), которые могут включать внутренние металлические слои для цепей через стеклянное отверстие (ТГВ), силовые или заземляющие пластины. Последняя цифра «10» указывает количество слоев на нижней стороне — зеркально отображая верхние слои для подключения к плате. Этот слой также служит для организации множества проводов на чипе.
Еще одним преимуществом подложки Intel 10-2-10 является то, что шаг контактных площадок составляет всего 45 мкм. Наконец, в многочиповые модульные корпуса встроены два моста EMIB, то есть несколько небольших чипов могут быть установлены на подложке и соединены между собой через EMIB. Intel также нашла решение, позволяющее избежать проблемы SeWaRe, связанной с растрескиванием стекла во время производства.
Производство стеклянных подложек гораздо сложнее, чем органических, поэтому относительно немногие компании разрабатывают эту технологию. Однако среди его сильных сторон — термостойкость, предотвращение деформации и улучшенная электрическая изоляция, позволяющая уменьшить задержки сигнала и помехи в плотно соединенных областях и увеличить плотность межсоединений.













